SiCパワー半導体の薄化・裏面研削
超精密グラインダーの加工事例2
「化合物半導体加工」に強い超精密研削盤はナガセインテグレックス。超精密グラインダーNSFseriesによるSiC・GaNパワーデバイスなどのバックグラインディング、薄化加工事例をご紹介。
SiC基板の
バックグラインディングを
最高の能率、最小の
コストで。
SiCの薄化・裏面研削とは、主にパワーデバイス等の用途で性能向上のためにSiC基板の厚みを薄化する加工のこと。BG、バックグラインディングとも呼ばれます。 NAGASEの定圧定量複合制御研削はSiCなどの高硬度な脆性材料を高能率・高精度に薄化・平坦化するために生み出された革新的な加工法です。
従来のインフィード研削に対して数倍の能率と少ない工具摩耗で6インチサイズのSiCも効率よく極薄化することが可能です。

加工サンプル



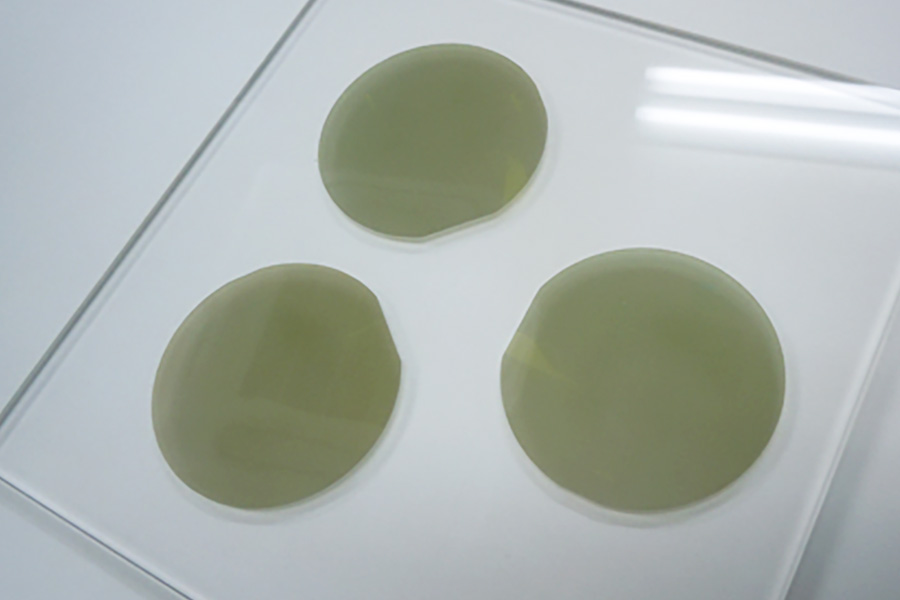
t20µmまで薄化したSiCウェハ
SORI:極少
サイズ:2インチ×3枚加工
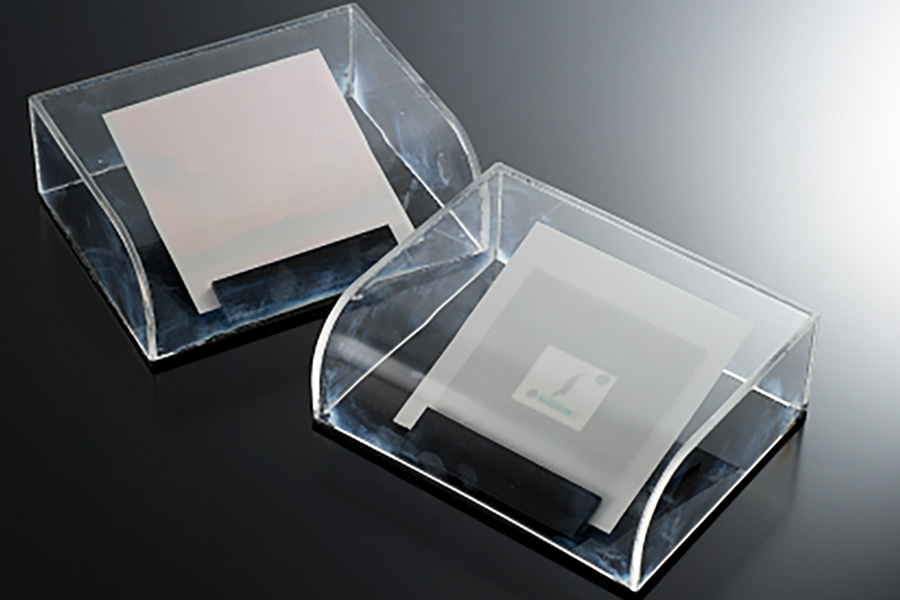



お問合せ先

ご興味がある加工や
ご検討中の加工がございましたら、
下記フォームより
お気軽にお問合せください。
ご相談は無料です。まずはご検討中の加工に関する精度、サイズ、素材などについてお聞かせください。
テスト加工、試作支援、設備利用に関しても、弊社テクニカルセンターのベテランエンジニアが最適な方法などを検討して、迅速にご回答させていただきます。(お急ぎの場合は各地域営業所まで)